Science/Research 詳細
産総研、パワー半導体用大口径SiCウェハの高速研磨技術を開発
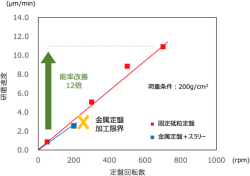
September, 2, 2021, つくば--産業技術総合研究所先進パワーエレクトロニクス研究センターウェハプロセスチーム 加藤智久研究チーム長らは、株式会社ミズホと不二越機械工業株式会社と共同でSiCウェハの平坦化を高速で達成するラッピング技術を開発した。特に、低速度だった鏡面化工程では従来の12倍の研磨速度が得られ、枚様式加工法の鏡面研削工程に匹敵する新たなバッチ式加工技術を確立した。
SiCウェハの各種研磨条件での研磨速度を比較
金属定盤とスラリーを使った加工では定盤回転数200 rpm超で加工が困難となった。一方で、固定砥粒定盤を用いた場合は700 rpmにおいても定盤回転数と研磨速度が比例することを確認した。これはスラリーを用いた代表的な加工条件(例:荷重200 g/cm2、回転数:50 rpm)と比較しておよそ12倍の研磨速度であり、従来の研削加工に匹敵する速度に達している。また、高速で研磨されたSiCウェハのRaは約0.5 nmであり、従来の鏡面研削加工と同等の表面品質を達成している。これらの成果から、固定砥粒定盤と高速研磨装置との組み合わせの優位性が示された。
またスラリーを使った研磨とは異なり、加工液としては水しか使用しないため環境負荷も少なく、水の供給量を制御して定盤を充分冷却しながら研磨能率を確保できる利点も新たに見いだされた。
定盤を使った研磨は主に加工圧力と定盤回転数で加工速度を制御するため、複数枚のウェハを同時に加工するバッチ式加工が可能である。SiCウェハを複数枚同時に加工した際の定盤回転数と研磨速度の関係では、ウェハ枚数が増え加工面積が増しても研磨能率を維持できることを確認した。すなわち、1バッチあたりのウェハ加工枚数を増やすことで、一枚当たりの加工時間を大幅に短縮できることが分かった。また、摩滅を抑えた高硬度の砥石を使うことで、研削加工より砥石損耗コストも抑えられるので、大口径SiCウェハを量産するプロセスの高速化と低コスト化の両立が実現可能である。
この技術の詳細は、2021年9月1日よりオンラインで開催される砥粒加工学会学術講演会(ABTEC2021)にて報告された。
(詳細は、https://www.aist.go.jp)












 レーザ・光関連製品Webガイド レーザ、オプトエレクトロニクスの最新製品をご紹介します。
レーザ・光関連製品Webガイド レーザ、オプトエレクトロニクスの最新製品をご紹介します。





