Science/Research 詳細
オーク製作所が高解像・高精度なダイレクト露光装置を開発
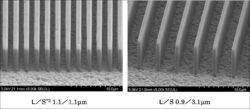
September, 10, 2025, 東京--NEDOは、委託事業である「省エネエレクトロニクスの製造基盤強化に向けた技術開発事業」の一環として、半導体製造装置の高度化に取り組んでいる。株式会社オーク製作所は、フォトマスクを使用せず、半導体基板に回路パターンを焼き付けるダイレクト露光装置で、従来よりも高い解像性および位置合わせ精度を実現可能な次世代技術と、その技術を搭載した装置を開発した。
これにより、チップレット集積技術で大型化が進んでいる先端半導体パッケージ(先端パッケージ)などで、高い位置合わせ精度や補正技術が要求される微細な配線回路形成に、ダイレクト露光技術が適用可能であることを実証した。
今後、同装置を2025年度内に製品化し、省エネルギー化の鍵となる先端パッケージの製造基盤の強化、安定供給および製造コストの低減に貢献する。
今回の成果
(1)高解像度化技術の開発
この事業でオーク製作所は、フォトマスクデータに従って空間光変調素子を高速で制御する技術と、高解像光学系を開発し、回路基板上の感光性材料に線幅1µmの回路を形成することに成功した。
2)微細めっき配線形成への適用性実証
今回開発した微細化技術により、有機材料上で線幅2µmの銅めっき配線形成が実現可能である事を確認した。
(3)位置合わせ精度の向上
位置合わせ精度は、設計座標値に対してどこまで正確に回路パターンを配置できるかの指標で、配線が微細化するほど、要求が厳しくなる。さらに、有機材を用いる先端パッケージでは、基材の伸縮に応じて露光するデータを補正する技術が求められる。このため、高精度で繰り返し再現性に優れた本体ステージとともに、基材上のアライメントマークを読み取る高精度カメラでのリアルタイム位置補正技術を開発した。これにより、510×515mmの露光サイズ全面に対して0.5µmの精度で回路パターンの配置が可能となった。
(4)ダイバイダイ・アライメント技術の開発
先端パッケージには、複数の配線接続用チップを中間基板であるインターポーザ内に埋め込み、その上に実装する半導体チップ同士を電気的に接続するタイプがある。その際、埋め込んだ接続チップの実際の位置と設計上の位置とのズレであるダイシフトが発生するため、それに対応した露光位置の補正が必要となる。オーク製作所は、リアルタイム位置補正技術を応用して、ダイシフトに対応可能なダイバイダイ・アライメント技術を開発した。
3.今後の予定
オーク製作所は、この装置を2025年度内に製品化するとともに、2025年度から2026年度にかけてシリーズ化を目指す。これにより、先端パッケージに関して多様化する顧客要求への対応と、省エネルギー化の鍵となる先端パッケージの製造基盤の強化、安定供給および製造コストの低減に貢献する。また、さらに性能を向上させた改良機の開発を継続し、進化する市場要求にも対応していく。


















